Навигация:Главная›Для ВУЗов, техникумов и ПУ›Оборудование PHYWE (Германия)›Физика›Физика рентгеновских излучений›Рентгеновское исследование кристаллических структур / метод Лауэ с цифровым датчиком рентгеновского изображения (XRIS)
Рентгеновское исследование кристаллических структур / метод Лауэ с цифровым датчиком рентгеновского изображения (XRIS)
Артикул: P2541606
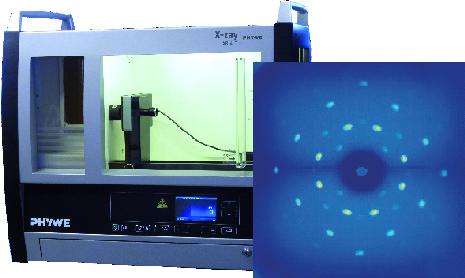
Цена: предоставляется по запросу
Принцип
Диаграммы Лауэ получаются при облучении монокристаллов полихроматическими рентгеновскими лучами. Этот метод в основном используется для определения симметрии и ориентации кристаллов. При облучении монокристалла LiF полихроматическими рентгеновскими лучами возникает характерная дифракционная картина. Эта картина фотографируется с помощью цифрового рентгеновского датчика XRIS.
Задание
- Дифракция Лауэ монокристалла LiF регистрируется с помощью цифрового рентгеновского датчика.
- Индексы Миллера соответствующих кристаллических поверхностей должны быть отнесены к отражениям Лауэ.
Основные термины
- Кристаллические решетки
- Кристаллические системы
- Классы кристаллов
- Решетка Браве
- Реципрокная решетка
- Индексы Миллера
- Амплитуда структуры
- Атомный форм-фактор
- Уравнение Брэгга
Программное обеспечение включено. Компьютер не предоставляется.
← Назад

